华天科技:股票投资分析报告
华天科技成立于 2003 年 12 月,总部位于甘肃省天水市,2007 年 11 月在深交所上市。华天科技主要从事半导体集成电路封装测试业务。产品主要应用于计算机、网络通讯、消费电子及智能移动终端、物联网、工业自动化控制、汽车电子等电子整机和智能化领域,与国内外近千家客户建立稳定良好的长期合作关系。华天科技坚持“内生增长+外延式并购”的发展战略,在 2018 年收购马来西亚封测公司 Unisem,进一步推进了华天科技国际化进程。目前华天科技在全球封测行业市占率第六,国内第三。
报告目录:

本报告全文约为9000字,本文为报告第一部分,完整报告首发于公众号“估股”。
①业务概述
华天科技成立于 2003 年 12 月,总部位于甘肃省天水市,2007 年 11 月在深交所上市。华天科技主要从事半导体集成电路封装测试业务。产品主要应用于计算机、网络通讯、消费电子及智能移动终端、物联网、工业自动化控制、汽车电子等电子整机和智能化领域,与国内外近千家客户建立稳定良好的长期合作关系。华天科技坚持“内生增长+外延式并购”的发展战略,在 2018 年收购马来西亚封测公司 Unisem,进一步推进了华天科技国际化进程。目前华天科技在全球封测行业市占率第六,国内第三。

华天科技历史沿革可追溯至 1969 年成立的永红器材厂,1995 年永红厂整体搬迁至甘肃天水,此时企业年亏损达 1000 多万元、负债近亿元,正处于倒闭边缘。肖胜利临危受命担任厂长,大刀阔斧地提出下岗分流、减员增效等八项具体措施,同时积极学习引进国内外先进技术,争取相关政策支持,1998 年亏损多年的永红器材厂成功扭亏为盈。
2003 年肖胜利等人承债式收购永红厂经营性资产,后将 IC 封测业务注入华天科技。国企改制背景下,2002 年 7 月肖胜利、刘建军等 1565 名永红厂职工与永红厂工会共同投资设立华天微电子,2003 年 1 月华天微电子承债式收购永红厂经营性资产,承接业务包括集成电路封装测试、模拟混合集成电路、DC/DC 与 AC/DC 电源模块、集成压力传感器、变送器的设计、生产、销售。2003 年 12 月华天微电子发起设立华天科技,并将集成电路封装测试业务相关的资产和负债注入华天科技中。
华天科技成立初期引入士兰微等主要客户作为股东,大客户加持下华天科技规模快速增长。华天科技成立至今专注于半导体集成电路的封装测试业务,设立时主要客户士兰微、上海贝岭、杭州友旺、无锡海威和深圳环宇均为华天科技股东。华天科技前期依赖大客户迅速扩张,随着规模持续增长和新客户不断导入,华天科技客户结构越来越分散。

2011年华天科技受让昆山西钛 35%的股权,此时昆山西钛是全球唯一实现使用TSV技术进行CSP封装量产并且良品率达到95%以上的厂商,主要生产手机、笔记本电脑及车载影像系统等使用的微型摄像头模组等光电子器件; 2014 年华天科技将昆山西钛更名为华天昆山公司,通过增资、收购的方式共持有其 93.04%的股权。
华天科技 2014 年 12 月以 4022.4 万美元购买 FCI 及其子公司纪元微科 100%的股权,此时 FCI 拥有 WLCSP、Flip Chip 以及 Wafer Bumping 等先进封装技术,能够提供嵌入式芯片封装和 3D 系统级封装解决方案,在先进封装技术方面拥有多项专利。同时,FCI 拥有众多的国际客户群体和多元化的应用市场。
华天科技 2015 年 12 月以 5000 万元增资后持有迈克光电 51%股权,迈克光电主要从事 LED 背光源的封装和 LED 照明灯具的研发生产,产品广泛用于手机、数码相机、便携式 DVD、GPS 及室内照明等。
华天科技 2019 年 1 月以 23.48 亿元收购 Unisem 公司 58.94%的股权。Unisem 成立于 1989 年,主要从事半导体封测业务,拥有 Bumping、SiP、FC、MEMS 等封装技术和能力,能够提供有引脚、无引脚以及晶圆级、MEMS 等各种封装业务,涉及通讯、消费电子、计算机、工业控制、汽车电子等领域。Unisem 主要客户包括 Broadcom、Qorvo、Skyworks 等国际 IC 设计公司,近六成收入来自欧美地区。

2021年,华天科技下属子公司成立产业基金,继续产业投资之路。

从华天科技的历史沿革来看,华天科技创始人属于资本家式创业,利用制度创新拯救华天科技前身国企性质的永红器械厂,并积极利用收购方式引入技术,将技术同市场相互结合,并利用股权绑定客户,成功依赖稳定的客户订单和大客户背书实现了快速发展。近些年来又借助资金的力量(自有、借款、二级市场融资等)不断收购新技术从中低端封测向中高端封测不断升级。无论是股权绑定客户还是股权收购,均属于一种制度设计能力。

主营业务构成:
目前华天科技集成电路封装产品可分为三大类:(1)引线框架类产品,作为华天科技的传统产品主要包括 DIP/SDIP 系列、SOT 系列、SOP 系列、SSOP/TSSOP/eTSSOP 系列、QFP/LQFP/TQFP 系列、QFN/DFN 系列等;该系列偏低端,产能主要分布于华天科技的天水基地和西安基地,收入规模由 2004 年的 2.1 亿元提升至 2018 年的 47.5 亿元,CAGR 为 24.8%,约占合并抵消前收入的 66.7%。
(2)基板类产品,主要包括 BGA/LGA 系列、FC 系列、MCM(MCP)系列和 SiP 系列等,产能主要分布于西安基地;基板类产品销量由 2010 年的 0.7 亿只提升至 2018 年的11.9 亿只,CAGR 为 42.5%;实现收入 11.6 亿元,约占合并抵消前收入的 16.2%。(上述两个业务后续无具体数据)
(3)晶圆级产品,定位高端产品,主要包括 WLP 系列、TSV 系列、Bumping 系列和 MEMS 系列等,产能主要分布于昆山基地。近年来受客户导入及折旧压力等因素影响,盈利能力短期承压。 2020 年受益于国产替代加速及行业景气度提升,昆山、南京等生产基地订单饱满,生产线处于满负荷运行,晶圆级产品盈利能力有望提升。 2020 年主营晶圆级封装产品的昆山基地实现营收 8.16 亿元,以此推断最新收入占比近10%,净利润0.74 亿元,净利率达到 9.12%,实现扭亏为盈,但目前对华天科技总体盈利贡献还不大。根据华天科技公告,其 2020 年晶圆级产能约 150 万片,产能利用率为 71.77%,2021 年一季度晶圆级产能为 40 万片,产能利用率为 83.45%。

虽然各类型产品业务数据未能找到最新信息,但也不难看出,华天科技虽然在尝试产品升级,当前仍然以中低端产品为主。升级略有成效,但是否能升级成功当前仍然并不能下定论。
②产品描述
集成电路封装行业属于生产性服务业,其服务过程如下:
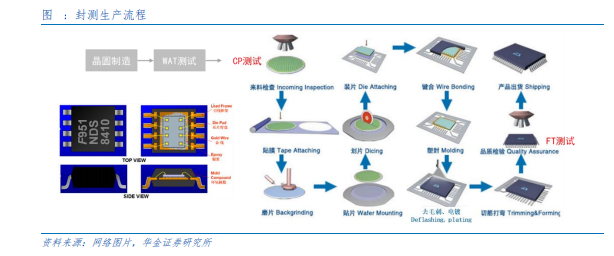

晶圆代工厂制造完成的晶圆在出厂前会经过一道电性测试,称为晶圆可接受度测试(Wafer Acceptance Test,WAT),WAT 测试通过的晶圆被送去封测厂。封测厂首先对晶圆进行中测(Chip Probe,CP)。由于工艺原因会引入各种制造缺陷,导致晶圆上的裸 Die 中会有一定量的残次品, CP 测试的目的就是在封装前将这些残次品找出来,缩减后续封测的成本。在完成晶圆制造后,通过探针与芯片上的焊盘接触,进行芯片功能的测试,同时标记不合格芯片并在切割后进行筛选。 CP 测试完成后进入封装环节,封装工艺流程一般可以分为两个部分,用塑料封装之前的工艺步骤称为前段操作,在成型之后的工艺步骤称为后段操作。基本工艺流程包括晶圆减薄、晶圆切割、 芯片贴装、固化、芯片互连、注塑成型、去飞边毛刺、上焊锡、切筋成型、打码等。因封装技术不同,工艺流程会有所差异,且封装过程中也会进行检测。封装完成后的产品还需要进行终测(Final Test,FT),通过 FT 测试的产品才能对外出货。整个过程基本都需要依靠机器+人工完成,虽然也有一定的技术含量,但整体生产要素上来看,偏资金+劳动力密集型。
目前华天科技各业务的在主体旗下各生产基地中的分布情况如下:

传统封装和先进封装以是否焊线做区分。传统封装的基本连接系统主要采用引线键合工艺,即通过引出金属线实现芯片与外部电子元器件的电气连接。由于密度较高可能导致引线之间电气性能的相互干扰甚至短路,传统封装的 I/O 密度受限。随着下游应用需求引领下的集成电路复杂度不断提升,先进封装应运而生。先进封装指主要以凸点(Bumping)方式实现电气连接的多种封装方式,旨在实现更多 I/O、更加集成两大功能。 传统封装技术包括 DIP、SOP、QFP、WB BGA 等,先进封装技术包括 FC、WLP、FO、3D 封装、系统级封装等(我们不对具体的封装技术原理做分析)。传统封装与先进封装间并不存在绝对的优劣之分与替代关系,但下游应用端对高算力、集成化的需求提升致使先进封装技术成为未来发展趋势。

目前先进封装最大的应用市场是移动设备和消费电子,2019年占比达85%。

③产业链

半导体是电子终端产品的关键组成部分,产业链可分为设计、制造、封测三大环节。半导体设计人员根据需求完成电路设计和布线,晶圆厂在晶圆上完成这些电路的制造,刻好电路图的晶圆再送到封测厂进行封装和测试,检测合格的产品便可应用于终端产品中。

目前半导体企业的经营模式可分为垂直整合和垂直分工两大类。采用垂直整合模式(Integrated Device Manufacturer,IDM)的企业可以独立完成芯片设计、晶圆制造、封装和测试等生产环节,代表企业包括英特尔、三星等。垂直分工模式为Fabless设计+Foundry制造+OSAT封测。Fabless 芯片设计华天科技采用无晶圆厂模式,只负责研发设计和销售,将晶圆制造、封装、测试外包出去, 代表企业包括高通、英伟达等;Foundry 晶圆代工厂仅负责晶圆制造,代表企业包括台积电、中芯国际等;OSAT(Outsourced Semiconductor Assembly and Testing)为外包封测企业,仅负责封装测试环节,代表企业如华天科技、长电科技、日月光等。目前行业分工化趋势要强于一体化趋势。
在Fabless模式下,芯片设计直接决定芯片的终端应用,在整个产业链中处于主导位置,对于华天科技等封测厂来讲,虽然芯片设计厂商位于其产业链上游,但往往是独立封装厂商的客户。因此虽然从产业链位置来看,封装厂位于产业链偏下游的位置,但作为生产者服务业,其本质服务于产业链中上游企业,因此本行业的关键能力可能在于研发或管理。
感谢阅读!

感谢阅读。后续的公司竞争力分析,发布于公众号:估股。

